Как правило, при разработке, производстве и эксплуатации полупроводниковых приборов сложно избежать небольшого количества отказов. В связи с постоянным повышением требований к качеству продукции анализ отказов становится всё более важным. Анализ конкретных неисправных микросхем может помочь разработчикам схем обнаружить дефекты конструкции прибора, несоответствие технологических параметров, необоснованную конструкцию периферийных цепей или сбои в работе, вызванные этой проблемой. Необходимость анализа отказов полупроводниковых приборов проявляется главным образом в следующих аспектах:
(1) Анализ отказов является необходимым средством для определения механизма отказа микросхемы устройства;
(2) Анализ отказов обеспечивает необходимую основу и информацию для эффективной диагностики неисправностей;
(3) Анализ отказов предоставляет инженерам-конструкторам необходимую обратную информацию для постоянного улучшения или исправления конструкции микросхемы и ее более разумного соответствия спецификации проекта;
(4) Анализ отказов может предоставить необходимое дополнение к производственным испытаниям и предоставить необходимую информационную основу для оптимизации процесса проверочных испытаний.
Для анализа неисправностей полупроводниковых диодов, аудионов или интегральных схем необходимо сначала проверить электрические параметры, а затем, после осмотра внешнего вида под оптическим микроскопом, удалить упаковку. Сохраняя целостность микросхемы, следует максимально сохранить внутренние и внешние выводы, места соединений и поверхность микросхемы, чтобы подготовить её к следующему этапу анализа.
Использование сканирующей электронной микроскопии и энергетического спектра для проведения данного анализа: включая наблюдение за микроскопической морфологией, поиск точек отказа, наблюдение и определение местоположения точек дефекта, точное измерение микроскопического геометрического размера устройства и распределения потенциала шероховатой поверхности, а также логическую оценку схемы цифрового вентиля (с использованием метода контрастного изображения напряжения); использование энергетического спектрометра или спектрометра для проведения данного анализа: микроскопический анализ элементного состава, анализ структуры материала или анализ загрязняющих веществ.
01. Дефекты поверхности и ожоги полупроводниковых приборов
Дефекты поверхности и выгорание полупроводниковых приборов являются распространенными видами отказов, как показано на рисунке 1, где представлен дефект очищенного слоя интегральной схемы.

На рисунке 2 показан дефект поверхности металлизированного слоя интегральной схемы.

На рисунке 3 показан канал пробоя между двумя металлическими полосками интегральной схемы.

На рисунке 4 показано разрушение металлической полосы и деформация перекоса на воздушном мосту в микроволновом устройстве.

На рисунке 5 показано перегорание сетки микроволновой лампы.
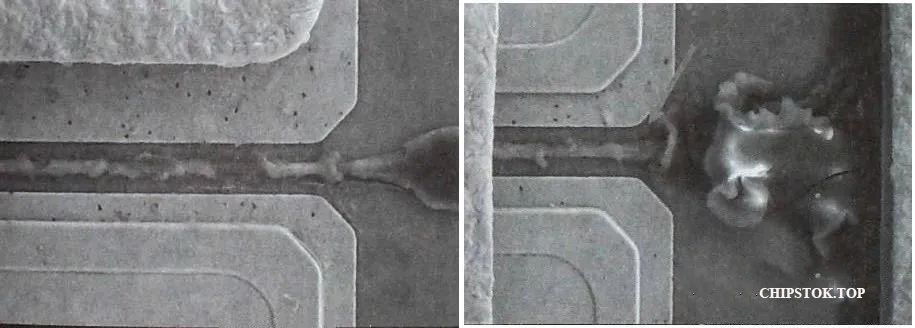
На рисунке 6 показано механическое повреждение интегрированного электрического металлизированного провода.
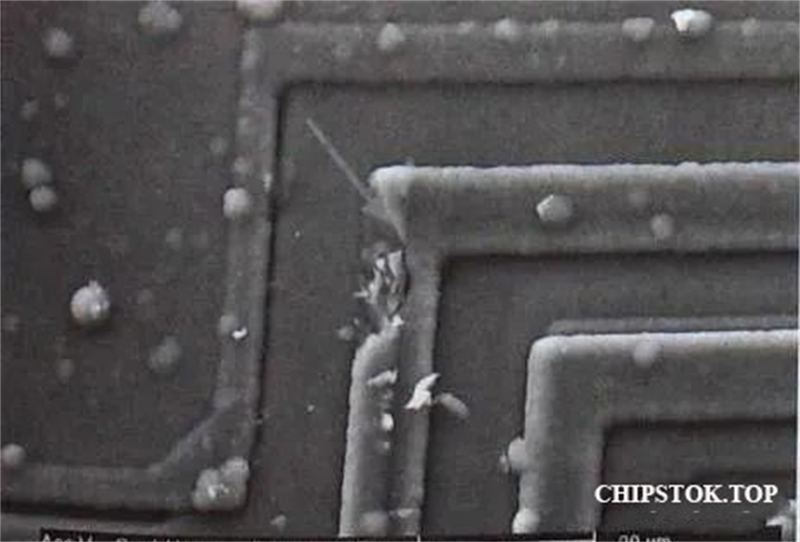
На рисунке 7 показано отверстие и дефект кристалла мезадиода.

На рисунке 8 показан пробой защитного диода на входе интегральной схемы.

На рисунке 9 показано, что поверхность кристалла интегральной схемы повреждена в результате механического воздействия.

На рисунке 10 показано частичное выгорание кристалла интегральной схемы.

На рисунке 11 показано, что диодный кристалл был пробит и сильно сгорел, а места пробоя перешли в расплавленное состояние.
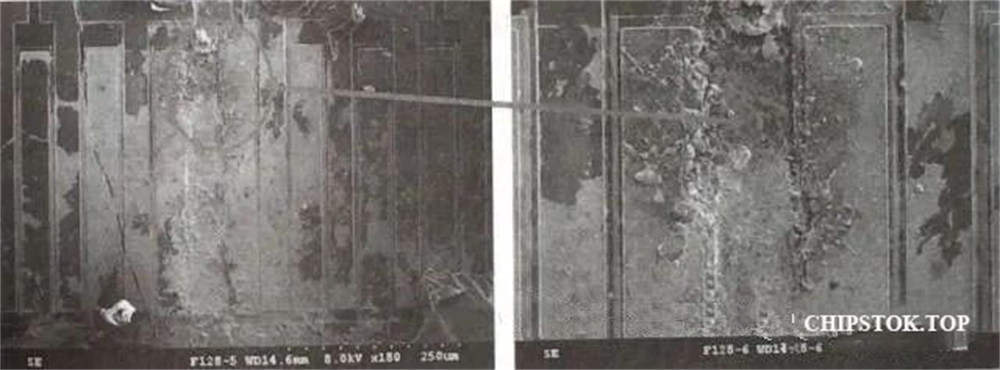
На рисунке 12 показан сгоревший кристалл микроволновой трубки из нитрида галлия, а точка сгоревшего металла представляет собой расплавленное распыляемое состояние.
02. Электростатический пробой
Полупроводниковые приборы подвержены риску статического электричества на всех этапах производства, упаковки и транспортировки, вплоть до установки на печатную плату, сварки, сборки и других. В процессе транспортировки они повреждаются из-за частых перемещений и легкого воздействия статического электричества, генерируемого внешним миром. Поэтому для снижения потерь следует уделять особое внимание защите от статического электричества при передаче и транспортировке.
В полупроводниковых приборах с униполярной МОП-трубкой и МОП-интегральной схемой особенно чувствительна к статическому электричеству, особенно МОП-трубка, из-за того, что ее собственное входное сопротивление очень велико, а емкость электрода затвор-исток очень мала, поэтому она очень легко подвергается воздействию внешнего электромагнитного поля или электростатической индукции и заряжается, а из-за генерации электростатического заряда ее трудно разрядить вовремя, поэтому легко вызвать накопление статического электричества, что приводит к мгновенному пробою прибора. Форма электростатического пробоя - это в основном электрический остроумный пробой, то есть тонкий оксидный слой сетки пробивает, образуя отверстие, которое замыкает зазор между сеткой и истоком или между сеткой и стоком.
По сравнению с МОП-транзисторами, МОП-интегральная схема обладает несколько лучшей антистатической способностью, поскольку её вход оснащен защитным диодом. При высоком электростатическом напряжении или импульсном перенапряжении большинство защитных диодов могут быть переключены на землю, но при слишком высоком напряжении или слишком большом мгновенном токе усиления защитные диоды иногда срабатывают сами, как показано на рисунке 8.
Несколько изображений, представленных на рисунке 13, представляют собой топографию электростатического пробоя МОП-интегральной схемы. Точка пробоя небольшая и глубокая, что соответствует состоянию расплавленного распыления.

На рисунке 14 показана картина электростатического пробоя магнитной головки жесткого диска компьютера.

Время публикации: 08 июля 2023 г.







